
ТОР 5 статей:
Методические подходы к анализу финансового состояния предприятия
Проблема периодизации русской литературы ХХ века. Краткая характеристика второй половины ХХ века
Характеристика шлифовальных кругов и ее маркировка
Служебные части речи. Предлог. Союз. Частицы
КАТЕГОРИИ:
- Археология
- Архитектура
- Астрономия
- Аудит
- Биология
- Ботаника
- Бухгалтерский учёт
- Войное дело
- Генетика
- География
- Геология
- Дизайн
- Искусство
- История
- Кино
- Кулинария
- Культура
- Литература
- Математика
- Медицина
- Металлургия
- Мифология
- Музыка
- Психология
- Религия
- Спорт
- Строительство
- Техника
- Транспорт
- Туризм
- Усадьба
- Физика
- Фотография
- Химия
- Экология
- Электричество
- Электроника
- Энергетика
Сущность и особенности процесса ионного легирования
Сущность и особенности процесса.
2. Функция распределения концентрации примеси по глубине и технологические режимы.
Техника процесса ионной имплантации.
4. Достоиства и недостатки ионной имплантации
Расчет режимов ионной имплантации (на ПЗ).
Сущность и особенности процесса ионного легирования
При ионном легировании (имплантации) на поверхность полупроводниковой пластины подается пучок ускоренных ионов примесей. Энергия ионов достаточна для проникновения их вглубь полупроводника. Движение ионов в полупроводнике обусловлено их начальной кинетической энергией. Ускоренные ионы, проникая в материал пластины, сталкиваются с атомами полупроводника и примесей (происходит ядерное торможение и изменение направления движения) и взаимодействуют с электронами (электронное торможение). В результате ионы теряют свою энергию и тормозятся.
Теория ионной имплантации ионов в аморфную подложку была разработана датскими учеными Линдхардом, Шарфом и Шиоттом и получила название теории ЛШШ.
При движении ионов в твердом теле (мишени) они теряют свою энергию и изменяют направление движения в результате взаимодействия с кристаллической решеткой. Различают два типа взаимодействий с решеткой — упругие и неупругие столкновения.
Упругими (ядерными) столкновениями называются такие, при которых энергия иона передается атомам мишени. Они имеют дискретный характер и сопровождаются значительным рассеянием ионов.
Неупругими (электронными) называются столкновения, в которых энергия иона передается электронам. При этом величина переданной энергии относительно мала и торможение иона можно рассматривать как квазинепрерывный процесс. Кроме того, вследствие существенной разницы масс иона и электрона неупругие потери не сопровождаются заметным рассеянием первичных ионов. По этой же причине упругие потери энергии «тяжелых» ионов (масса иона больше массы атома мишени) приводят к сравнительно малым углам рассеяния и траектория их движения более прямолинейна, чем у легких ионов (масса иона меньше массы атома мишени).
Теряя свою энергию в атомных и электронных столкновениях, ионы замедляются и, наконец, останавливаются внутри мишени. Так появляются внедренные ионы. Вследствие того, что число столкновений и энергия, передаваемая при столкновениях, являются переменными величинами, характеризующими случайный процесс, глубина проникновения ионов не будет одинаковой.
В процессе имплантации ионы, двигающиеся в кристаллической решетке, сталкиваются с ее атомами. На пути иона остается след из смещенных атомов решетки. Возникают радиационные дефекты решетки. Одиночный ион с энергией в несколько десятков электрон-вольт может создать на своем пути несколько тысяч подобных дефектов. По пути движения возникают области с нарушенной структурой – кластеры – размером 5…10 нм. С ростом энергии ионов увеличивается число дефектов, ухудшающих её электрофизические свойства. При большой дозе легирования кластеры могут смыкаться, образуя обширные аморфные области. Возможно разрушение поверхностного кристаллического слоя полупроводника и превращение его в аморфный.

Рис. 1. Траектория движения внедренных ионов: -------- отклонения атомов полупроводника при столкновении с ионами; ______ траектория движения иона
Минимальная доза легирования, при которой возникает аморфный слой, называется дозой аморфизации. Поэтому энергию ионов ограничивают величиной приблизительно 200 кэВ, а глубина залегания максимума концентрации не превышает 0,5...0,7 мкм, дозу легирования ограничивают значением 1014…1015см—2.. Аморфизация поверхности кремниевой пластины под действием ионов фосфора происходит более интенсивно, чем под действием ионов бора. Доза облучения, необходимая для аморфизации поверхности кремния, составляет 6,2 10 14 см-2.
Введенный ион может попасть в вакантный узел и стать донором или акцептором, но вероятность остановки иона в узле маленькая. Большинство имплантированных ионов находится в междоузлиях, где они не является электрически активными.
После ионного легирования производят отжиг пластин при температуре 600…900°С, необходимый для снижения числа радиационных дефектов и активации примесей. При отжиге смещенные атомы основного полупроводника возвращаются в нормальное положение в узлы кристаллической решетки. Примесные атомы перемещаются в вакантные узлы. Происходит активация примесей и они становятся донорами или акцепторами. Переход в активное состояние облегчается вследствие наличия радиационных дефектов, имеющих высокую плотность. Поэтому время отжига составляет 15…20 мин, и внедренные примеси заметно не перераспределяются.
2. Функция распределения концентрации примеси по глубине и технологические режимы.
При движении ионов в подложке в результате столкновений с атомными ядрами и электронами они теряют свою энергию и останавливаются. Длина пути иона от поверхности подложки (точка А на рис. 3.10) до точки останова (точка В) называется длиной пробега R, а ее проекция на направление первоначального движения – проекцией пробега Rx. Именно эта величина и определяет глубину проникновения иона в подложку.
Вследствие того, что число столкновений и энергия, передаваемая при столкновениях, являются переменными величинами, характеризующими случайный процесс, глубина проникновения ионов не будет одинаковой. Ионы с одинаковой энергией E 0 массой, M 1 и атомным номером Z 1 падают на поверхность подложки и движутся по индивидуальным траекториям, которые показаны для трех ионов на рис. 2. Путь, который проходят ионы, называется полным пробегом – Rp. Ионы после торможения останавливаются в точках, положение которых характеризуется проецированными пробегами Rp 1, Rp 2, Rp 3.
Практическое значение для определения глубины внедрения ионов имеет средняя длина проекции полного пробега на направление начальной скорости ионов.  - средний нормальный пробег.
- средний нормальный пробег.
|
|

Рис. 2 - Пробеги ионов в твердом теле
Вследствие случайного характера столкновений пробеги ионов в полупроводниках распределяются по некоторому статистическому закону (закон Гаусса), который характеризуется средним проецированным пробегом λср ( ) и среднеквадратичным отклонением σ.(Δ Rp.) На практике очень важен еще параметр Δ R ┴ – это проекция пробегов на ось y (боковое рассеяние).
) и среднеквадратичным отклонением σ.(Δ Rp.) На практике очень важен еще параметр Δ R ┴ – это проекция пробегов на ось y (боковое рассеяние).
Траектория движения ионов имеет вид ломаной линии (рис.30), каждый прямолинейный участок, которой соответствует пробегу иона до столкновения с атомом решетки. Полная длина пробега иона до остановки складывается из отдельных участков ломаной траектории.
Распределение ионов при разориентированном внедрении (или в аморфную подложку) определяется законом Гаусса, так как столкновения ионов с атомами решетки носят вероятностный характер

где Q - доза облучения, см-2;  - среднеквадратическое отклонение нормальных пробегов, см; х - глубина внедрения ионов, см.
- среднеквадратическое отклонение нормальных пробегов, см; х - глубина внедрения ионов, см.
 |
Глубина проникновения ионов зависит от их энергии, массы и направления внедрения относительно кристаллографических осей. Чем больше энергия, тем больше толщина имплантированного слоя. На рис. 3 показаны распределения концентраций примеси N(x) для одной и той же дозы легирования Nл, но для разных энергий ионов.
Рисунок 3 – Профили распределения электрически активных атомов бора при различных энергиях ионного пучка
Максимум распределений (рис.3) соответствует не поверхности пластин, как в случае термической диффузии, а расстоянию от поверхности, равном среднему нормальному пробегу ионов  . С увеличением энергии максимум распределения сдвигается в глубь подложки, это позволяет получать скрытые заглубленные слои с проводимостью противоположного типа.
. С увеличением энергии максимум распределения сдвигается в глубь подложки, это позволяет получать скрытые заглубленные слои с проводимостью противоположного типа.

Глубина залегания полученного при этом p-n -перехода определяется выражением




При извлечении корня следует учитывать оба знака, поскольку в подложке после проведения ионного легирования возможно одновременное образование двух p-n- переходов.
Величины  и Δ
и Δ  связаны между собой соотношением
связаны между собой соотношением

Концентрация спадает и уменьшается в 2, 10 и 100 раз по отношению к N max соответственно на глубинах

При невысокой энергии ионов слой р -типа образуется на поверхности, а его толщина определяется из условия
Na(x0)= Nд,
где Nд – исходная концентрация доноров в пластине n -типа.
С увеличением энергии электронов максимум распределения концентрации смещается вглубь подложки. Точки  и
и  соответствует металлургическим границам p-n переходов. Область с противоположным типом проводимости образовалась непосредственно в глубине.
соответствует металлургическим границам p-n переходов. Область с противоположным типом проводимости образовалась непосредственно в глубине.



Рисунок 4– Распределение ионов с низкими (а) и высокими (б) значениями энергий и образование p-n переходов

Распределение пробегов ионов в аморфных и монокристаллических подложках может сильно отличаться друг от друга. Если направление падающего ионного пучка совпадает (или почти совпадает) с одним из кристаллографических направлений монокристаллической подложки, то число тормозящих атомов отличается от соответствующего числа атомов в произвольно (по отношению к пучку) наклоненном монокристалле. В этом случае ионы способны проникнуть в подложку на значительно большую глубину (пунктирная линия на рис. 6), чем в случае аморфной мишени. Данный эффект носит название эффекта каналирования. Его механизм иллюстрирует рис. 5, на котором показана «плоская» кристаллическая решетка мишени и ион, влетающий в нее под углом j относительно атомных плоскостей. Для возникновения эффекта каналирования необязательно, чтобы ион двигался строго параллельно атомным плоскостям. Достаточно, чтобы угол j, под которым ион влетает в кристалл, не превышал некоторый критический угол jкр, значение которого зависит от межплоскостного расстояния кристаллической решетки, типа иона и его энергии.
 Рисунок 5 – Эффект каналирования
Рисунок 5 – Эффект каналирования
 |
Рисунок 6 – Распределение примесных атомов по глубине
Техника ионного легирования. Получение ионов, их ускорение и фокусировку осуществляют в установках ионного легирования.

Рисунок 7 – Схема установки для ионной имплантации
Цифрами на рисунке обозначены: 1 – источник ионов (газоразрядная камера); 2 – вытягивающий электрод; 3 – электромагнитная фокусирующая линза; 4 – ускоряющий электрод; 5 – отклоняющие ионный пучок пластины; 6 – входная и выходная диафрагмы; 7 – магнитный сепаратор; 8 – подложка; 9 – держатель подложки.
Пары легирующих элементов поступают в ионизационную камеру, где возбуждаются высокочастотным или дуговым электрическим разрядом. Образовавшиеся ионы (P+,As+,B+ и др.) вытягиваются из камеры с помощью электрода, на который подается отрицательный потенциал (10...20 кВ), и поступают в магнитный масс - сепаратор – устройство для разделения ионов. Наличие в установке для ионной имплантации магнитного сепаратора обеспечивает высокую чистоту легирования.
Принцип действия сепаратора основан на взаимодействии магнитного поля, созданного в сепараторе, с движущимися ионами. В результате действия силы Лоренца ионы движутся по дуге окружности, радиус R которой определяется выражением

где m - масса иона; U - ускоряющее напряжение; q - заряд иона; B – магнитная индукция. Поскольку радиус кривизны траектории зависит от массы иона, то это дает возможность настроить сепаратор таким образом, чтобы через его выходную щель проходили только ионы определенной массы. Все другие ионы будут задерживаться диафрагмой и подложки не достигнут.
На выход масс - сепаратора попадают только ионы нужного вида. Далее ионы ускоряются в электрическом поле (напряжение для ускорения находится в пределах от 10 до 300 кВ) и фокусируются в пучок с плотностью тока от 0,1 до 100 мкА/см2 и площадью сечения 1...2 мм2. Перемещение пучка для последовательного облучения всей поверхности обеспечивает система сканирования. Ускоряющее напряжение и ток пучка поддерживают с большой точностью, что обеспечивает высокую воспроизводимость параметров легированных слоёв.
Для исключения эффекта каналирования ионное легирование осуществляют при углах разориентации пластины больше критических (7…8°).
Легирования обычно осуществляют через маску. Маски формируют из SiО2, Si3N4, W, Mo, Al, Au и др. Толщина масок превышают длину пробега ионов в этих материалах и составляет 0,1...2мкм. Например, для масок из SiО2 и Si3N4 достаточна толщина около 0,5мкм.
Ионный пучок направлен перпендикулярно поверхности, а боковое рассеяние ионов небольшое. Вследствие этого горизонтальные размеры легированной области точно соответствуют отверстию в маске (рис. 8). Это позволяет получать области значительно меньших размеров по сравнении с легированием методом диффузии.
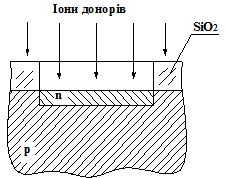
Рисунок 8– Локальное ионное легирование кремния
Для локального легирования применяют маски из пленок, в которых средняя длина пробега ионов при заданной энергии достаточно мала. Например, при Е=150 и 40 кэВ для оксида кремния – 0,4 и 0,14 мкм, а для нитрида кремния – 0,3 и 0,1 мкм соответственно.
Ионное внедрение примесей наряду с диффузией широко используется в технологии изготовления ИМС. В некоторых случаях при получении слоёв большой толщины ионное легирование применяют как первый этап – загонка, а затем проводят второй этап легирования – разгонку при высокой температуре (900...1000оС), объединяя ее с отжигом. Таким способом обеспечивается более точное дозирование примесей.

Рис. 9 Формирование глубоких профилей: а - ступенчатый процесс;
б - комбинирование имплантационной загонки с диффузионной разгонкой
В ИМС на биполярных транзисторах ионное внедрение используется для получения областей транзисторов, формирования скрытых слоёв, формирование практически любого профиля легирования и т.п. В ИМС на МДП-транзисторах ионным легированием получают МДП-транзисторы с само совмещенным затвором, управляют пороговым напряжением и т.п.
Ионное легирование широко применяют при создании БИС и СБИС.
Основные преимущества ионного легирования:
· низкая температура процесса (вплоть до комнатных температур),
· точность и воспроизводимость глубины и степени легирования,
· обеспечивает высокую чистоту легирования, практически исключающую
· возможность формирования практически любого профиля,
· точное воспроизведение рисунка маски при локальном легировании,
· высокая производительность и легкость автоматизации.
Недостатками ионного легирования является:
· необходимость отжига,
· сложность воспроизводимого легирования слоёв толщиной более 1 мкм,
· сложность оборудования,
· расфокусировка луча при обработке пластин больших диаметров
· радиационные дефекты хотя и устраняются в значительной степени отжигом, тем не менее оставшаяся часть может негативно сказаться на работе полупроводниковых приборов.
Вопросы и задания для самопроверки
1. В чем состоит процесс ионного легирования?
2. Для чего используют ионное легирование в процессе изготовления микросхем?
3. Объясните, как можно получить скрытые слои с помощью ионного легирования.
4. Что такое радиационные дефекты?
5. Для чего проводится активация примесей?
6. Объясните принципы действия установки для ионного легирования.
7. Какие преимущества и недостатки ионного легирования?
| <== предыдущая лекция | | | следующая лекция ==> |
| Лекция 3. Наука и техника в античном мире | | | Техническая документация и учебные пособия. |
Не нашли, что искали? Воспользуйтесь поиском: