
ТОР 5 статей:
Методические подходы к анализу финансового состояния предприятия
Проблема периодизации русской литературы ХХ века. Краткая характеристика второй половины ХХ века
Характеристика шлифовальных кругов и ее маркировка
Служебные части речи. Предлог. Союз. Частицы
КАТЕГОРИИ:
- Археология
- Архитектура
- Астрономия
- Аудит
- Биология
- Ботаника
- Бухгалтерский учёт
- Войное дело
- Генетика
- География
- Геология
- Дизайн
- Искусство
- История
- Кино
- Кулинария
- Культура
- Литература
- Математика
- Медицина
- Металлургия
- Мифология
- Музыка
- Психология
- Религия
- Спорт
- Строительство
- Техника
- Транспорт
- Туризм
- Усадьба
- Физика
- Фотография
- Химия
- Экология
- Электричество
- Электроника
- Энергетика
Вимірювання товщини епітаксіальних плівок
З всього різноманіття методів вимірювання товщини епітаксіальних плівок зупинимося на тих, які отримали найбільше розповсюдження у виробництві напівпровідників, тобто реалізують функції метрологічного забезпечення технологічного процесу.
До цих методів пред'являють ряд вимог: вони повинні бути неруйнуючими, достатньо точними і в той же час продуктивними. Цим вимогам різні методи відповідають в різному ступені, і тому їх вибір здійснюється з урахуванням конкретно поставленої технологічної задачі.
Оскільки плівка і підкладка є монолітною композицією, основна проблема при вимірюваннях товщини плівки полягає у визначенні положення фізичної межі розділу між ними. Саме невизначеність у виявленні цієї межі служить основним джерелом погрішності.
Різницеві методи
Найпростішим представляється метод вимірювання товщини нарощенного шару шляхом віднімання початкової товщини підкладки із загальної товщини структури. Варіантом цього методу є зважування пластини до і після нарощування на нього епітаксіального шару. Виходячи з різниці у вазі і знаючи густину матеріалу, можна визначити d. Іноді в процесі нарощування частину підкладки екранують маскою з графіту, кварцу або іншого матеріалу, потім за допомогою звичайного вимірювального інструменту визначають висоту сходинки, що утворилася.
Точність цих методів невисока через невизначеність в положенні межі шар-підкладка, при газовому травленні підкладок перед нарощуванням, через взаємну дифузію матеріалу між підкладкою і шаром, нерівномірність шару по товщині.
Тому вказані методи, хоча і володіють високою експресністю і наочністю, застосовуються, як правило, тільки для настройки і відладки технологічного процесу.
Визначення товщини по тетраедричних дефектах
Тетраедрічні дефекти утворюються в більшості випадків безпосередньо на межі підкладка-шар. Вони є двовимірними дефектами, утвореними при відхиленні від нормальної послідовності упаковки атомів в кристалі. Дефекти упаковки в результаті селективного травлення виявляються у вигляді рівносторонніх трикутників в площині (III), рівнобедрених трикутників в площині (II0) і квадратів в площині (I00).
Виміряючи довжину сторони дефекту упаковки  на поверхні плівки, обчислюють товщину плівки d по формулах:
на поверхні плівки, обчислюють товщину плівки d по формулах:
- для площини (111)  ;
;
-
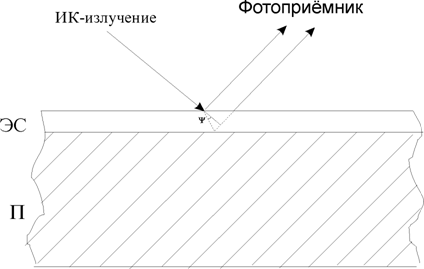 |
для площини (100)
 ; (5.6)
; (5.6)
- для площини (110)  .
.
Мал. 5.3. Схема інтерференційного методу вимірювання товщини плівки

При всій своїй простоті і достатньо високій точності вказаний метод є руйнуючим, оскільки вимагає виявлення дефектів за допомогою того, що труїть. Крім того, вдосконалення технології нарощування підвищує вірогідність отримання бездефектних шарів. Тому даний метод також як і різницеві застосовується переважно в чисто технологічній меті.
ЕС – епітаксіальний шар; П – підкладка; d – товщина плівки; l – довжина шліфа; a - кут косого шліфа.
Мал. 5.2. Схема методу косого шліфа вимірювання товщини плівки
ЕС – епітаксіальний шар; П – підкладка; y - кут заломлення в плівці.
Метод фарбування шліфа (сколу)
Цей метод, хоча він і є руйнуючим, найбільш точний і простий, а тому і займає провідне місце в технології напівпровідників. Як правило, для контролю партії структур, нарощуваних в єдиному процесі, в установку завантажується спеціальна пластина, на якій нарощується контрольна структура-супутник. Саме на цій структурі-супутнику і проводяться вимірювання основних паспортних параметрів, у тому числі і товщина, яка характеризує всю партію.
Суть методу полягає в тому, що на структурі спочатку створюється косий скол або шліф (рис. 5.2). В промисловій практиці частіше користуються методом круглого (або кульового) шліфа.
Шліфи піддають процесам електрохімічного осадження міді, труїть або анодного окислення, в результаті яких межа розділу шар-підкладка забарвлюється (декорується).
Це дає можливість виміряти не d, а більш доступну величину l. Чим більше l (або радіус кульового шліфа), тим з більшою точністю можна визначити d.
У разі косого шліфа, знаючи його кут a і виміряючи під мікроскопом відстань l від краю шліфа до межі забарвленої області, можна обчислити товщину плівки:
d = l × sin a (5.7)
Цим методом можна виміряти товщину шарів більше 1 мкм з точністю ±(5¸10)%. Перевагою методу є можливість вимірювання d в широкому діапазоні значень практично для структур будь-яких типів (n-n+, p-p+, n-p). Недоліком методу, крім руйнуючої дії, є його відносно низька продуктивність.
Не нашли, что искали? Воспользуйтесь поиском: